新产品介绍
哑光黑色成膜
- 超过光学密度(OD)5、具备高遮光率的喷墨成膜工艺
- 实施低反射处理,实现反射率(R%)0.1% 和 明度(L)1
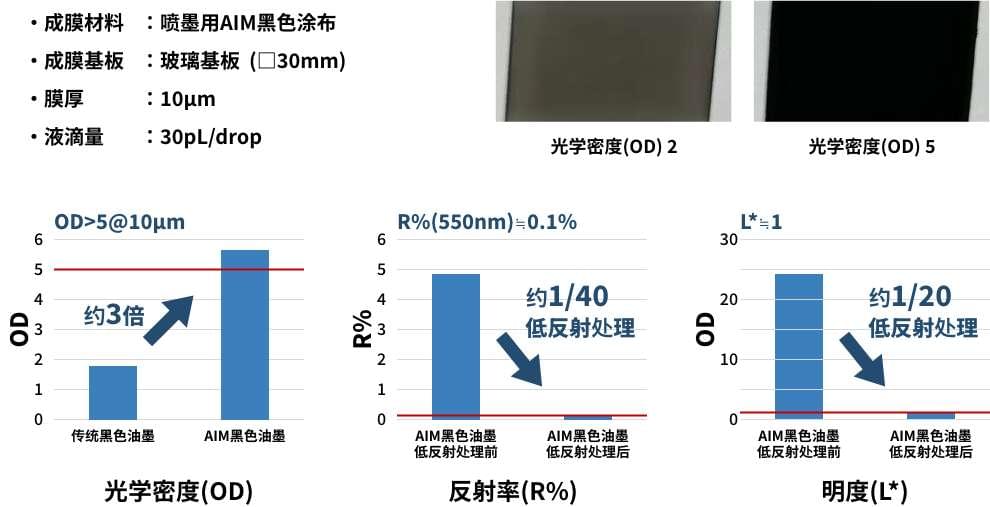
各类基材改质开始至成膜处理的一站式交钥匙工艺设备
喷墨工艺的特征
- 在适当的位置涂布最适的涂布量实现自由图案
- 标准配备:独自的膜厚控制(渐变涂布)涂布技术
- 标准配备:抑制咖啡环效应(膜边隆起)的涂布控制技术
适用例
- 显示器/微型LED:黑矩阵
- 高性能摄像头模组、镜头、棱镜等:超低反射、高遮光性
- AR/VR光学系: 通过部分遮光,提高对比度、降低杂散光
- 激光光源: 高遮光

磁浮AMC模块生产系统 *AMC:自动物料连结, Automated Material Connect
- 提供光学粘合材料等多种树脂材料涂布制程的一站式解决方案。
- 采用磁浮循环搬送系统,进行模块生产制程的最佳化,实现低成本工艺制程。
-
根据具体生产要求可以联动喷墨打印和其他高精度涂布等多种机构。
还可以增加覆膜或大气贴合机构等进行系统提升。 -
用途:智能手机或平板电脑等信息终端的模块式制程,车载中央信息显示器等信息显示器件的模
块制程,各种涂布·贴合制程。
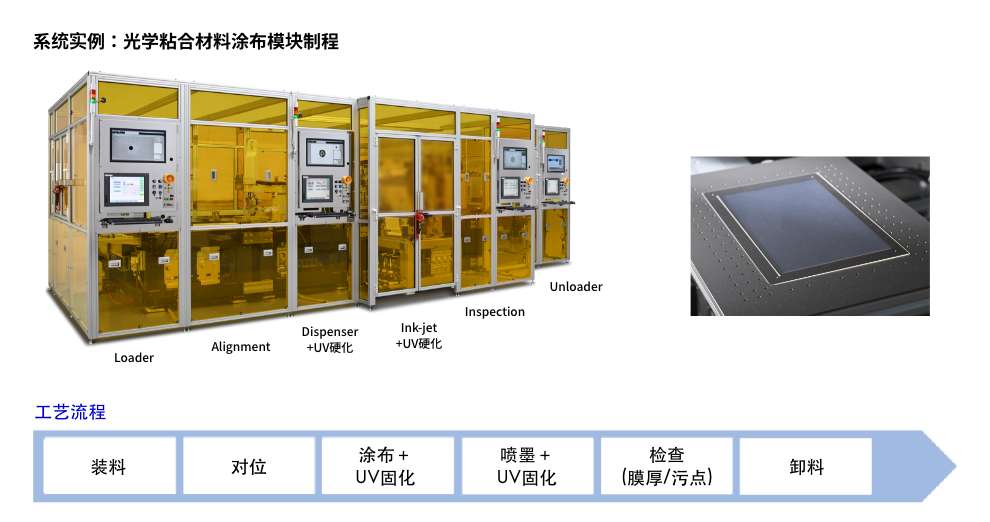
| No. | 项目 | 规格 |
|---|---|---|
| 1 | 材料尺寸 | 340mm×250mm |
| 2 | 材质 |
光学粘合材料等 关于具体材质请垂问确认 |
| 3 | 适用材料 |
光学粘合材料等 关于具体材质请垂问确认 |
| 4 | 线节拍 |
12秒以上 按系统结构不同 |
| 5 | 系统提升 | 请见右边所示的系统提升机构 |
| 6 | 系统尺寸 |
W8,200×D3,200×H2,400mm 按系统结构不同 |
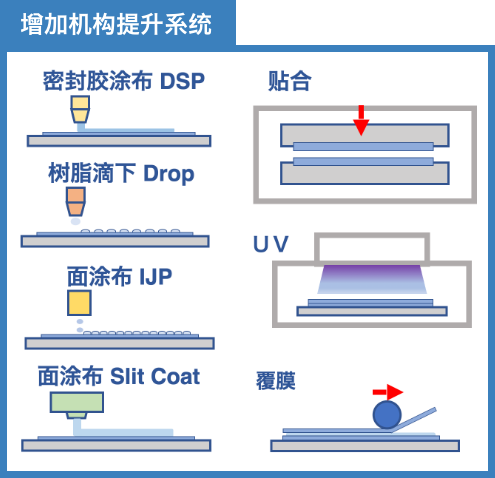
对应晶圆焊锡植球设备
- 将半导体封装基板的焊锡球搭载技术应用于晶圆上,实现高良品率。
- 因为独特助焊剂印刷技术的高品质·稳定性生产独自
- 采用新型搭载头提高生产性
- 紧凑设计
- 对应SECS/GEM,OHT/AGV(选择)
特征
-
助焊剂印刷
・间隙印刷抑制助焊剂印刷模糊
・单方向印刷机构使印刷位置更稳定
・最少清扫次数 -
焊锡球搭载
・新型Infinity(无限)搭载头(三连旋转,密闭式)
- 高吞吐量
- 最少清扫次数(和旧款比1/3)
- 提高焊锡球使用效率(和旧款1/2)

適用
- WLCSP,FOWLP等的晶圆
检查修补设备
- 可以将检查修补设备検査和只求设备系统化

| No. | 項目 | 规格 | |
|---|---|---|---|
| ABM-04G-WFS | ABM-04S-WFS | ||
| 1 | 晶圆尺寸 | Φ300mm Φ200mm |
Φ300mm Φ200mm |
| 2 | 搬送系统 | Load port (FOUP or FOSB) |
Load port (FOUP or FOSB) |
| 3 | 适用球径 | 40um~300um | 80um~300um |
| 4 | 对位精度 | <±10um | <±15um |
| 5 | 助焊剂印刷 |
间隙印刷 (单方向) |
间隙印刷 (单方向) |
| 6 | 焊锡球搭载 | 新型Infinity(无限)搭载头(三连旋转,密闭式) | 新型Infinity(无限)搭载头(三连旋转,密闭式) |
| 7 | 球移位率 | <20ppm 评价条件按敝公司标准。 |
<30ppm 评价条件按敝公司标准。 |
| 8 | 吞吐量 |
65UPH 评价条件按敝公司标准。 |
40UPH 评价条件按敝公司标准。 |
| 9 | 设备尺寸 | 3995(W)x2150(D)x2020(H)mm | 3555(W)x2150(D)x2020(H)mm |
| 10 | 首个被重量 | 约3500kg | 约3300kg |
对应Φ30μm直径植球系统(已取得专利)
- 应用喷墨技术,实现适用于窄间距化生产的均匀助焊剂涂布
- 使用高速旋转涂布头的稳定植球性能,也有利于提高生产效率
- 不间断连续的On the fly飞行检查可以高速检查和修补
- 对窄间距化的微小焊锡球植球工艺,提供有效于提高良品率和生产效率的综合解决方案
特征
-
助焊剂涂布
不使用传统模板的喷射涂布 -
球搭载
实现高吞吐量的新型旋转涂布头 -
检查修补
连续高速检查(On the fly飞行检查)
□120mm单元基板的检查修补 - 无模板,助焊剂使用效率高
适用
-
封装基板
(FCCSP, FCBGA, MCP/MPU, 2.5/3D, FOPLP等) -
晶圆
(WLCSP,FOWLP等)

| No. | 项目 | 规格 |
|---|---|---|
| 1 | 材料尺寸 |
基板:Max.340L×250W(mm) 晶圆:Max.12“(φ300mm) |
| 2 | 基板种类 | 环氧玻璃等封装用基板 晶圆 |
| 3 | 适用球径 | 30um~300um |
| 4 | 助焊剂涂布设备 | 喷墨涂布 |
| 5 | 焊锡球搭载设备 |
高速搭大量搭载,掉球率: 30ppm 条件按敝公司标准。 |
| 6 | 检查修补设备 |
On the fly飞行检查 最大单元基板□120mm |
| 7 | 吞吐量 |
65UPH 条件按敝公司标准。 |
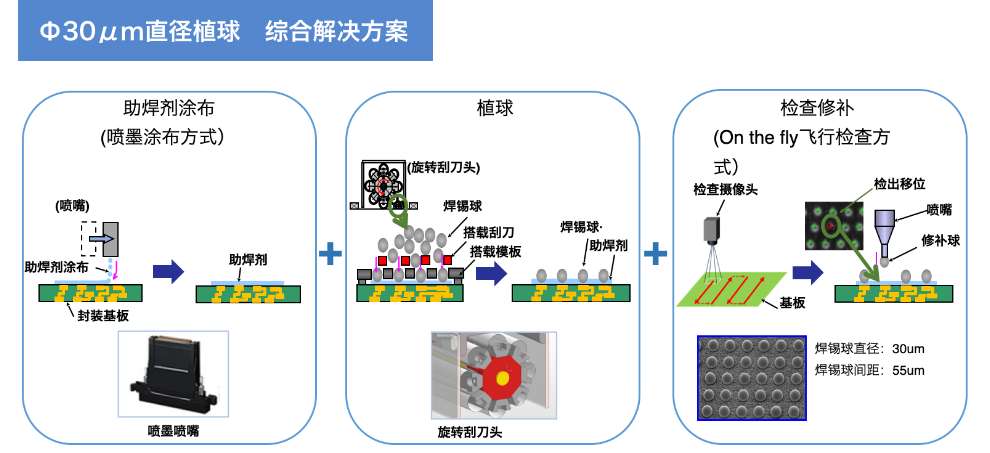
等离子激光修补设备 ALR-04G-P4 (专利申请中待决)
- 提高良品率的半导体封装等离子激光修补设备
- 可对搭载焊锡球后的回流焊以及清洗助焊剂制程中发生的焊锡球脱落不良进行检查修补
- 将等离子技术和激光技术相融合,实现了局部回流焊
- 把影响半导体封装品质的回流焊制程减少到最少限度
特征
- 对回流焊和清洗助焊剂制程中发生的焊锡球脱落不良进行检查修补
- 材料(封装基板,晶圆)高速全面检查
- 助焊剂涂布・高精度焊锡球搭载
- 用等离子和激光焊接焊锡球
- 离线或在线方案
适用
-
封装基板以及切割后的单元基板
(FCCSP, FCBGA, MCP/MPU, 2.5/3D, FOPLP等) - 晶圆(WLCSP,FOWLP等)
| No. | 项目 | 规格 |
|---|---|---|
| 1 | 材料尺寸 |
基板:Max.340L×250W(mm) 晶圆:Max.12“(φ300mm) |
| 2 | 材料种类 | 环氧玻璃等封装用基板 晶圆 |
| 3 | 适用球径 | 40um~300um |
| 4 | 检查方式 | On the fly飞行检查 |
| 5 | 焊锡球焊接方式 | 等离子+激光 |
| 6 | 节拍 (修补+焊锡球焊接) |
50秒 评价条件按敝公司标准。 |
| 7 | 设备尺寸 |
W2,600×D2,400×H2,150mm (除搬送机构,突出部外) |
| 8 | 设备重量 | 3,000 kg |


RGB 喷墨(Ink-Jet)印刷系统
- 有机发光二极管(OLED)/ 量子点有机发光二极管(QDOLED)/ 量子点微型发光二极管(QDμLED)/量子点电致发光(QDEL) ,适应各种成膜材料
- 对应大型基板的工艺设备和控制机构已有丰富实绩
- 涂布~成膜 整体解决方案(涂布,干燥,烧成,环境控制)

采用适应材料特性的喷嘴
- 采用适应含有QD等微粒子的材料的循环机构以及精密温调机构
- 采用智能喷墨和控制器优化波形
标准装备的量产技术
- 矩阵补正和涂布间距补正
- 全喷嘴射出状态的高速检查和液滴量/滴下位置检查
- 利用一次性校正机构缩短停歇时间
减压干燥制程的优化
- 利用丰富实绩的真空控制技术和数据解析优化设计的结构
- 液体解析,VCD减压干燥,液滴举动模拟
对应多样化像素设计
- 像素Pen Tile排列,平行排列,线槽排列
焊锡球搭载设备
- 40um球量产线的实现
- 新型旋转式搭载头对应高产能(比现有型加快25%)
- 对应高性能,大型化封装单元的“On the fly”检查功能
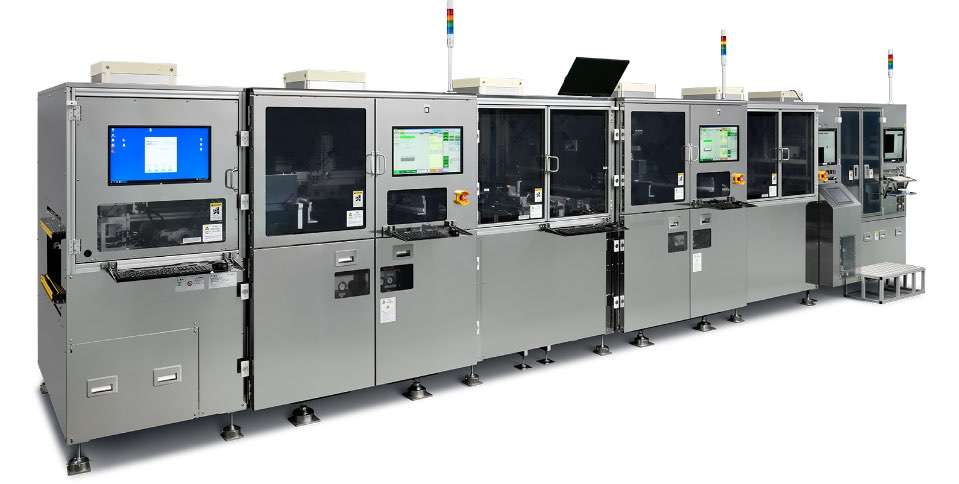
| 主要项目 | 规格 |
|---|---|
| 设备配置 | Flux / Ball printer / Inspection & Repair |
| 基板转印方式 | Pick & Place (Vacuum pad) or Pick & Place (Clamp) |
| 生产量(节拍) | 65sec |
| 适用基板尺寸 | Max. 420 x 300 - Min. 200L x 75W(mm) |
| 适用焊锡球直径 | 40 - 500(μm) |
| 重复定位精度 | < ±10um |
| 搭载率 (No Ball率) | < 20ppm |
| 检查方法 | On the fly inspection (Non-stop imaging) |
| 最大适用单元尺寸 | 120.0 × 120.0(mm) |
| 检查时间(参考值) | 約16sec./ 1/4 panel(144unit/panel) |
| 修补功能 | With Flux W/O Flux Available |
| 多余焊球除去功能 | Available |
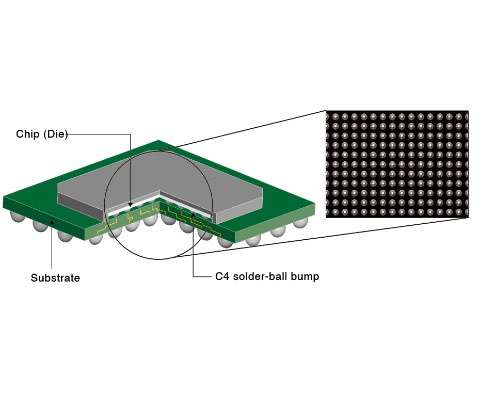
微型显示生产系统
- 硅圆片8,12寸兼用整体ODF解决方案
- 确保间隙均匀性和高生产效率
- 丰富的微型显示生产实绩 [有机发光二极管(OLED),硅基液晶 (LCOS),高温多晶硅(HTPS)]
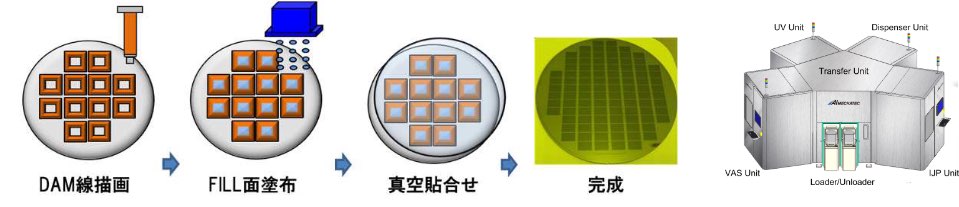
整体解决方案
- 高成品率
- 最短装调时间,对应稳定量产
- 工艺诀窍
集成为一套系统
-
筑堤(Dam)涂布设备
高速・细线描绘(600um2) -
充填物(Fill)滴下喷墨设备
对应高粘度(~1,000mPa/s) -
真空贴合设备
高精度(3σ≦0.2um)
智能生产系统
- 自动生产工厂的自律适应系统,对应远程支援
- 工艺设备自动化和材料搬运系统的统合管理
- 配备洁净环境生产模式的解决方案
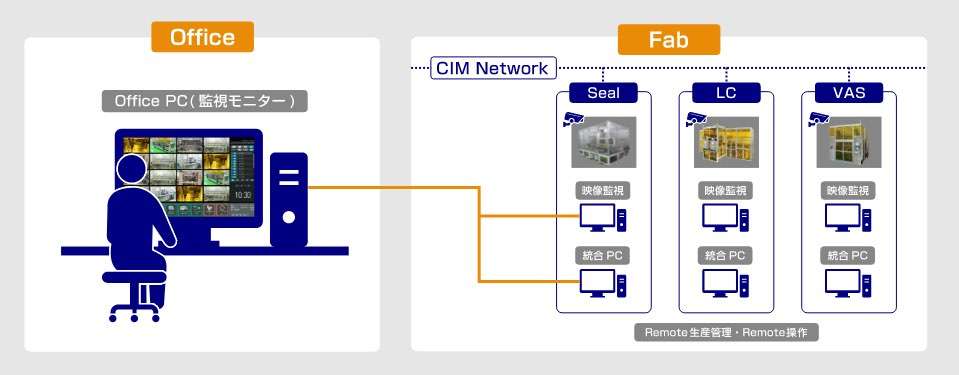
系统统合管理
- 远程统合管理
- 工艺优化管理
- 节能管理
- 保全管理
工艺设备的自动化
- 自动送料供料机构
- 自动化生产准备机构
搬运(导线)的自动化
- 自动搬运系统
- 自动化准备室
-
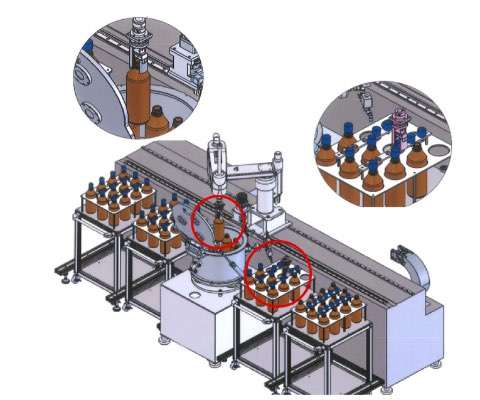
自动化准备室 -

自动搬运系统 -
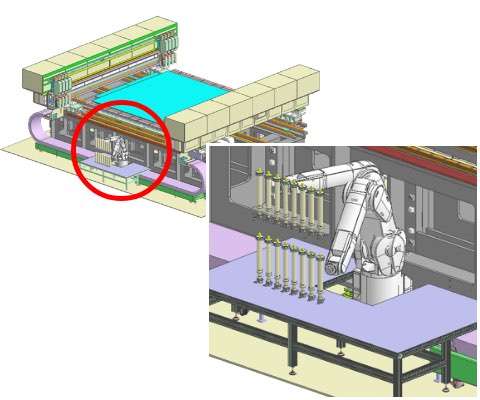
自动化生产准备机构
